

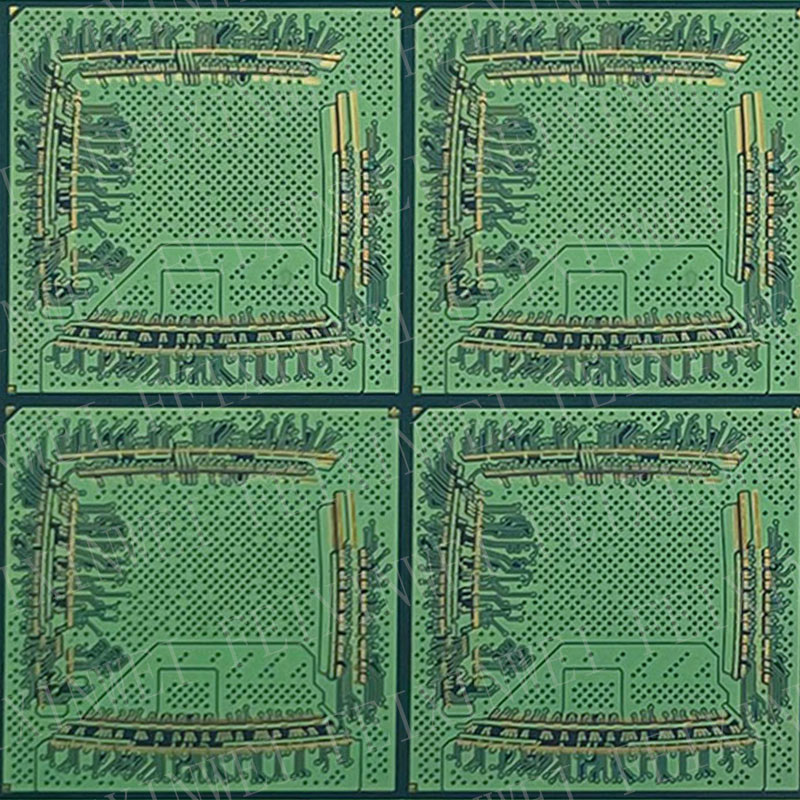
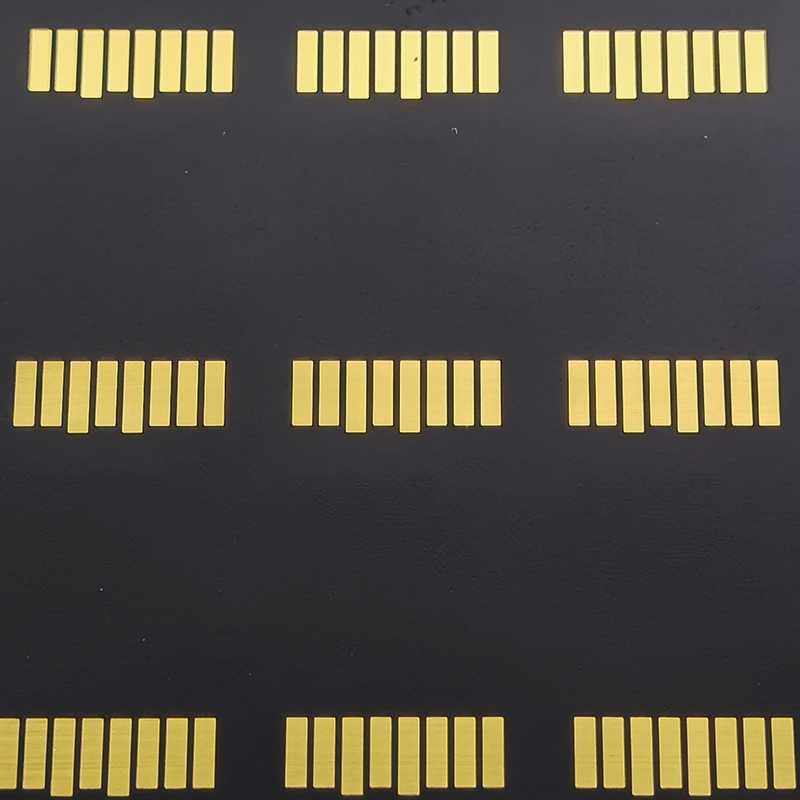

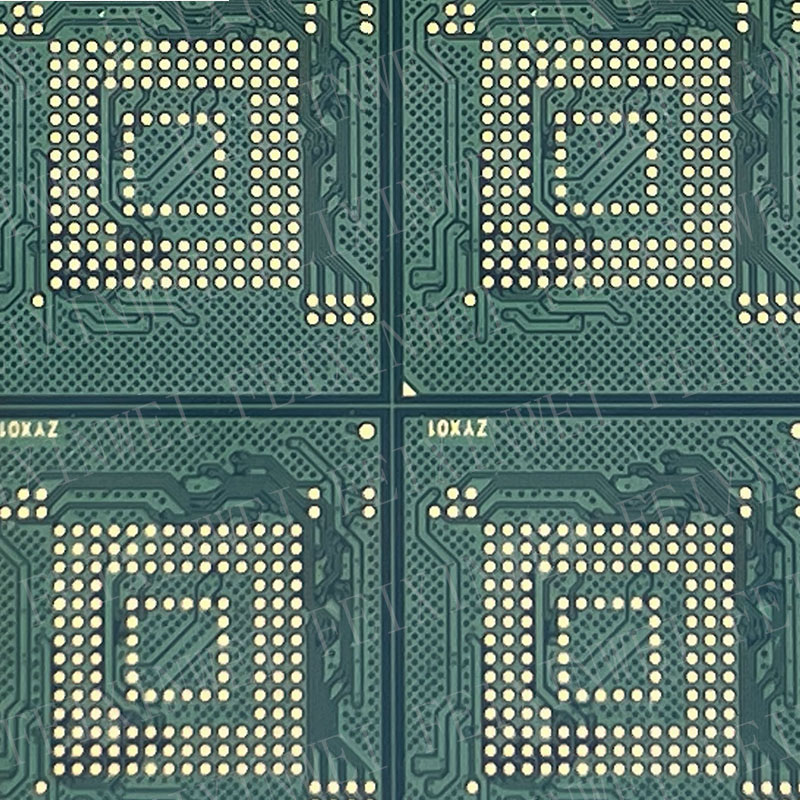

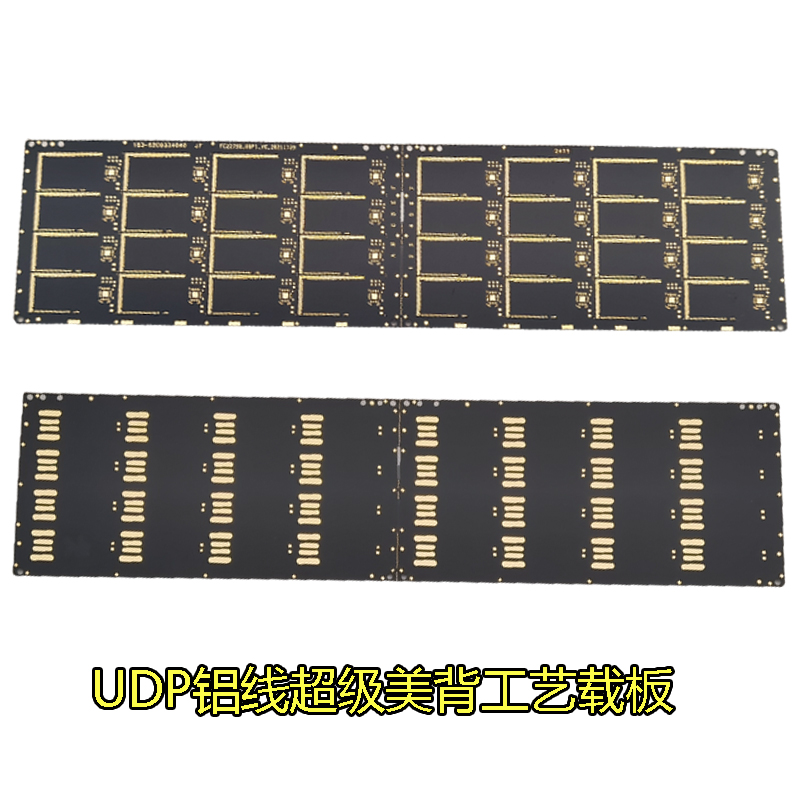

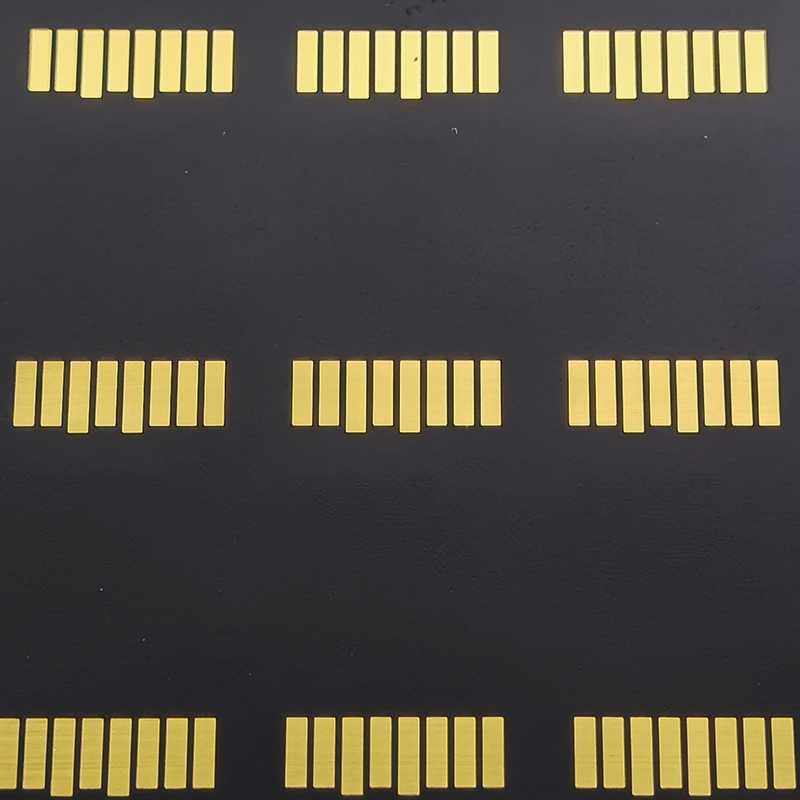

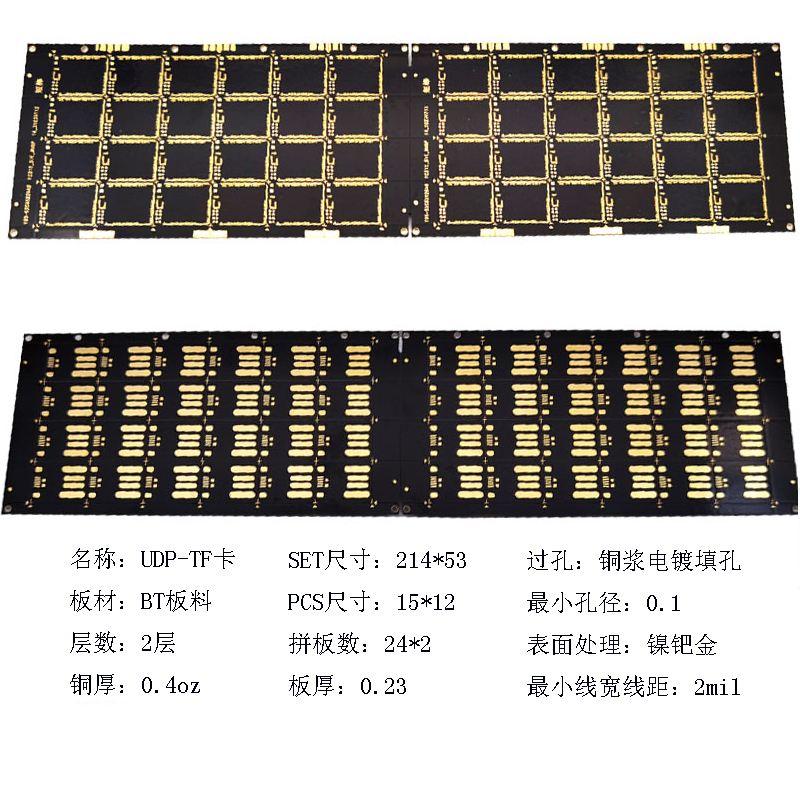
飞芯微科技,IC封装基板领域新兴企业,成立于2019年,以专业的技术开启IC封装基板的制造征程,主要致力于IC封装基板的研发和生产,产品定位1-8层UDP,TF卡,MEMS,LGA,CSP,SIP,BGA等BT类IC封装基板的样品和批量生产,专注于服务半导体封测企业致力于提供稳定的产品,快速的交期,最好的服务,助力中国半导体发展与创新。
飞芯微科技新投资扩产响应产业西迁政策,贵州飞芯微已于25年3月正式投产,设计最小线宽线距30um,激光钻孔0.05mm,常备库存材料品牌生益,BT,Mitsubishi,Toshiba,LG,斗山等,聘用经验丰富的专业英才及技术人员进行管理,是一家初具规模、设备完善、管理严格、品质卓越的专业IC封装基板线路板制造厂家。本公司引进全套先进的线路板生产设备,配备最先进LDI曝光机,高精度激光钻孔,先进的层压对位系统,全工艺在线AOI实时监测,阻焊常备太阳油墨,样品交期12-30天,样品全部采用专业IC封装基板飞针测试机100%测试出货。
产品广泛应用于:手机、电脑、智能家居、汽车等电子产品及IC封装等领域。我们的服务宗旨是: “质量第一、服务至上、价格合理、交货快捷!”
查看更多
实际应用于:通信、网络、微处理器/控制器、门阵列、内存包等产品
1. 热匹配性好。
2. 成本低
3. 电性能好。
4. 在回流焊过程中可利用焊球的自对准作用
广泛应用于:微处理器,图像处理器,特殊化功能IC,高端服务器、ASIC、FPGA、ADAS
1. 应用十分广泛,在智能驾驶,5G应用,大数据,AI等领域需求激增。
2. 解决了电磁干扰(EMI)和电磁兼容(EMC)的问题。
3.倒装封装形式芯片背面可接触空气能直接散热,同时基板亦可通过金属层散热,或在背部加装散热片 。
4. 强化后的芯片散热能力,能极大的提高芯片在高速运行时的稳定性。
广泛应用于:包扩但不局限于无源器件、RFIC、功率放大器(PA)、
开关器件、稳压器、晶体等。
(RF modules)的封装载体类型
1. 层压基板,成本低,工艺成熟,导电导热性能优良。
2. 低温共烧陶瓷(TLCC)技术使用陶瓷作为基板或者载体。
3. 在硅或镓砷上生成的薄膜(TF)无源器件,使用半导体工艺制成。
广泛应用于:存储器(如闪存、SRAM和高速DRAM)、网络、数字型号处理器
(DSP)、混合信号和RF领域、专用集成电路(ASIC)、微控制器、电子显示
屏等方面。
CSP的优势
1. 封装引脚数越多的CSP尺寸远比传统封装形式小、易于实现高密度封装。
2. 电学性能优良,内部布线长度比QFP和BGA短的多,寄生引线电容和电
阻、电感均很小,从而使信号传输延迟大为缩短。
3. 采用裸芯片安装,内部无芯片封装延迟及大幅度提高了封装密度。
4. 散热性能优良。
广泛应用于:数字化处理系统;光通迅;传感器以及微机械MEMS等领域。在计算机,自动化,通讯行业的对讲机、手机、光传输、光接入、云存储、4G路由器、船用通讯、基站、射频微波、雷达产品大量应用。
SIP的优势
1. 广泛的应用领域和设计弹性
2. 改善电磁干扰(EMI)与信号完整性(SI)
3. 简化元件采购,改善终端产品的制造效率
4. 开发时间较SoC的开发时间短
广泛应用于:笔记本电脑、桌上型电脑、CPU、绘图处理器(GPU)、消费性电子应用、电脑运算、网路、伺服器、处理中心和HOC等
(FCCSP)的优势
1. 应用领域和行业广泛,增长前进好。
2. 晶元整合实现了前所未有的紧密系统。
3. 铜柱凸块成为覆晶封装的互联首选。
4.受惠于导体中断制程聚合趋势,覆晶封装的市场占有率高。

先进封装中的2D,2.5D,3D封装详解
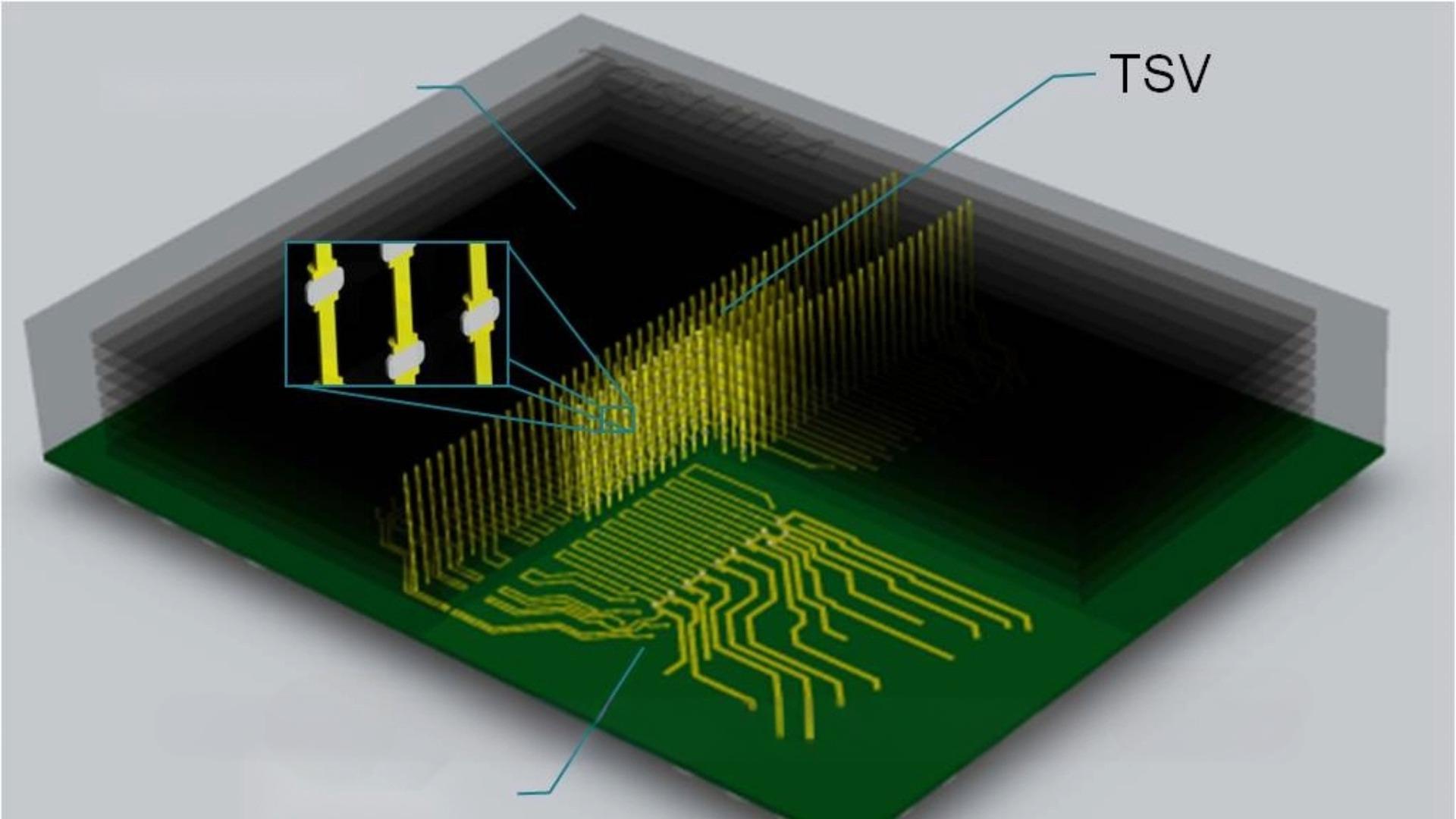
车企60天账期承诺之下,汽车芯片供应商有何利好?

“HBM+先进封装”双引擎,北方华创冲刺半导体设备新高地!

中国大陆封测强势崛起,台湾省大厂加码先进封装

BT断链风暴!日商交期暴拉20周,ABF载板报价看涨

停产!DDR4囤货价格暴涨!

H20芯片禁令致45亿美元损失,英伟达毛利率承压;华硕:今年AI PC重点市场是日本;南亚科技:下半年DRAM营运有望量价齐扬

晶圆级扇入封装

扇出封装(csp)的应用及其市场发展

NAND SSD存储芯片封装载板,NAND三季度价格涨幅将扩大